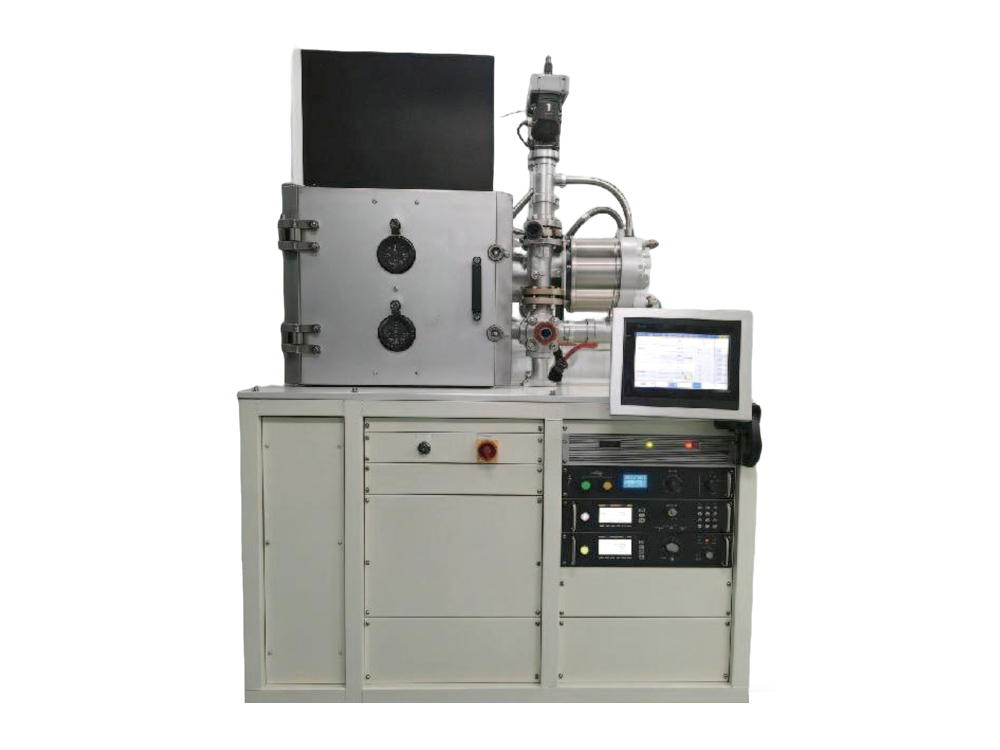
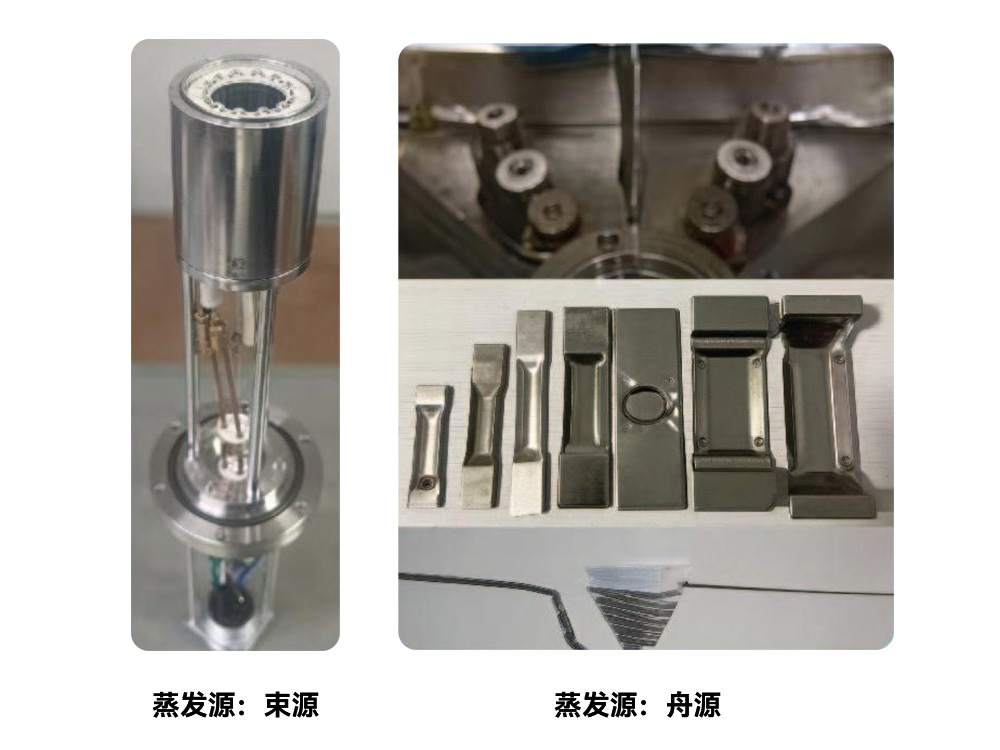
基本配置与功能
|
序号 |
基本配置 |
主要参数与功能 |
|
序号 |
蒸发源:舟源 |
容量:1–3CC,钨丝+氮化铝/氧化铝。 |
|
序号 |
蒸发源:束源 |
容量:5、10CC,钽丝+氧化铝/PBN坩埚;室温–500度,精度±1度。 |
|
1 |
膜厚系统 |
InficonSQC–310膜厚仪+2套晶振探头,速度精度0.1A/S,厚度精度1A。 |
|
2 |
基片台 |
最大可装载基片300mm*300mm,带有旋转功能;带有加热、水冷功能(二选一)。 |
|
3 |
真空系统 |
真空系统采用分子泵+机械泵的形式,带有旁抽系统,可不停主泵开腔(可选配低温泵)。 |
|
4 |
控制系统 |
采用PLC+PC机或PLC+触摸屏的方式,自动化程序操作。包含一键式抽气与充气功能。误操作互锁功能。 |
|
5 |
手套箱 |
(选配) 可与镀膜设备连接,使取放基片在无水无氧的环境中进行。 |
|
6 |
样品室 |
(选配) 采用真空机械手取放片,实现工艺室不破真空取放片。 |
✔设备基片尺寸:100*100mm;210*210mm;300*300mm等多种规格可选;可用于中低温金属(如银、金、铝、铟等),化合物(如LiF,SnO)以及有机材料的蒸发镀膜。
设备介绍-测试数据



基本配置与功能
设备最大可放置基片尺寸300*300mm;可用于制备中高温金属(钛、镍、银等)及氧化物(氧化硅,氧化铝等)等薄膜。
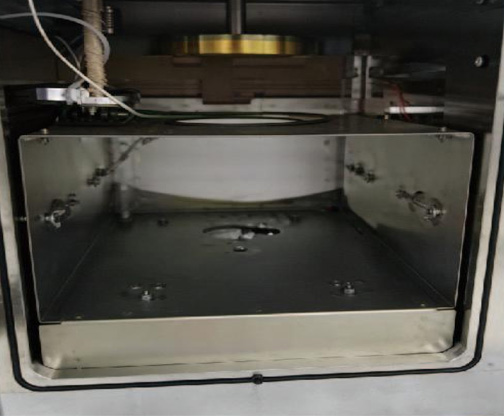
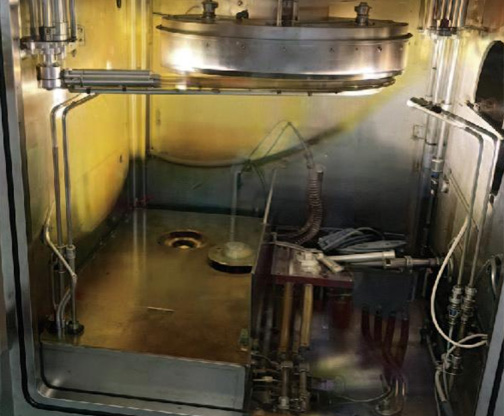



基本配置与功能
基本配置 | 主要参数与功能 |
电子枪源 | 选用进口电子枪,坩埚为4穴或6穴,旋转切换。膜厚均匀性达到95%以上。 |
热阳源 | 可配置一组至多组热阻蒸发源,采用舟或坩埚的形式;直流电源驱动,膜厚均匀性达到95%以上。 |
真空系统 | 真空系统采用分子泵+机械泵的形式,带有旁抽系统,可不停主泵开腔(可选配低温泵)。 |
控制系统 | 采用PLC+PC机或PLC+触摸屏的方式,自动化程序操作。膜厚控制系统可自动低温泵化进行蒸镀速率控制。 |
手套箱 | (选配)可与镀膜设备连接,使取放基片在无水无氧的环境中进行。 |
样品室 | (选配)采用真空机械手取放片,实现工艺室不破真空取放片。 |
除主体电子束镀膜机外,还可以配置手套箱及样品室,实现氮气中取放片或真空中取放片。